氧化镓P型研究有望突破—中国台湾研究团队发表最新研究成果
磷离子注入技术在蓝宝石衬底上生长p型导电Ga₂O₃薄膜
Ray Hua Horng a,*, Xin-Ying Tsai a, Fu-Gow Tarntair a, Jia-Min Shiehb, Shao-Hui Hsub, Jitendra Pratap Singh c, Guan-Cheng Sud, Po-Liang Liu d
a 国立阳明交通大学电子制定,新竹,台湾,ROC
b 台湾半导体研究所(TSRI),国家应用研究实验室,新竹,30091,台湾;ROC
c 物理系,德里科学研究所,新德里,110016,印度
d 国立中兴大学精密工程学研究生制定,台湾台中40227,ROC
*通讯作者
电邮地址:rayhua@nycu.edu.tw(R.H.洪)。
摘要
本研究利用不同的磷离子注入技术,包括低、中和高剂量,研究了非定向掺杂的β-Ga2O3外延层的电学性质。这些外延层是通过金属有机化学气相沉积法在蓝宝石衬底上生长。
具体而言,低剂量注入包括磷离子,浓度分别为1.6✕1013、1✕1012和2.5✕1012 atoms/ cm2,注入能量分别为100、50和40 keV。中等剂量注入使用相同注入能量的磷离子,浓度为1.6✕1014、1✕1013和2.5✕1013 atoms/cm2。最后,高剂量注入采用相同注入能量的磷离子,浓度为1.6✕1015、1✕1014和2.5✕1014 atoms/cm2,注入能量分别为100、50和40 keV。利用离子在物质中的停止和射程软件模拟了注入参数,通孔(SIMS) 二次离子质谱测量了(P) 磷离子的实际浓度。随后,将Ni和Au沉积在退火后的磷注入β-Ga2O3涂层上,然后在600℃的氮气环境中快速退火1分钟,进行霍尔测量。通过霍尔测量评估了磷注入的β-Ga2O3外延层的电学性质。值得注意的是,中等和高剂量注入的β-Ga2O3外延层显示出P型行为。根据霍尔测量,中等和高剂量的P型β-Ga2O3外延层的电阻率分别为9.699和6.439 Ω cm。此外,这些剂量的空穴载流子浓度分别为1.612✕1018和6.428✕1017。因此,中等和高剂量的磷离子注入被证明是获得P型Ga2O3的有效方法。为了进一步探讨β-Ga2O3晶格内取代磷缺陷的缺陷形成能和费米能级,采用了第一性原理密度泛函模拟。
1. 介绍
为了满足新兴应用不断变化的需求,半导体技术的快速发展要求探索能够提供增强电子性能的新型材料,特别是在功率器件应用领域。在目前正在考虑用于功率器件的材料中,氧化镓(Ga2O3)是一个非常有前途的候选材料,其特点是具有4.9 eV的宽带隙,8 MV/cm的高击穿电场强度以及出色的热稳定性[1-3]。这些独特的属性使Ga2O3成为高功率电子器件、光电子和电力电子器件应用的理想选择[4-7]。
近年来,大量的研究工作致力于定制Ga2O3的电学特性,以进一步提高其性能。这些调查集中在不同的方法上,包括同质结外延生长[8-10]、蓝宝石衬底上异质结外延生长[11-13]以及掺杂技术的研究[14-18]。特别重要的是双极掺杂,它具有调制半导体的电学和光学特性的潜力,使功能材料和器件[19]的制造成为可能。通过离子注入和原位掺杂制备n型Ga2O3取得了显著进展[20-22]。然而,实现p型掺杂仍然是一个艰巨的挑战。超宽带隙(UWBG)半导体是下一代高性能光电和电子器件的关键材料,其p型掺杂已被证明非常难以实现[23,24]。
尽管Ga2O3被报道为“原生”p型半导体氧化物,即使施主缺陷[25]引发强烈补偿,但缺乏对Ga2O3材料是否确实通过金属有机化学气相沉积(MOCVD) 对应于β-相生长的广泛验证。
以往对p型Ga2O3的研究主要集中在使用氮、锌和镁作为掺杂剂。与(金属,N)组合共掺杂被认为是一种获得有效p型β-Ga2O3 [26]的潜在方法。理论研究已经证明了n掺杂β-Ga2O3薄膜中的p型导电性,显示霍尔空穴浓度为3.19✕1015 cm-3,霍尔空穴迁移率为23.1 cm2/V.s,从而阐明了潜在的p型电导率机制[27]。然而,对β相中单(P)磷原子取代的影响尚未进行研究。
在这项研究中,我们通过第一性原理计算来研究(P) 磷掺杂对β-Ga2O3的影响,特别是研究其理论空穴迁移率和相关的散射机制。此外,离子注入结合快速热退火(RTA)是研究半导体电导率的一种行之有效的方法。它也可以作为在MOCVD系统中修改工艺和安装前驱体之前评估掺杂行为的有价值的技术。例如,在使用SiH4或TEOS进行原位掺杂之前,采用硅离子注入制备n型Ga2O3。在这项工作中,我们探索创新的(P) 磷离子注入技术,利用不同的离子注入参数,实现p型β-Ga2O3受主掺杂。我们的目标是深入了解这种材料中p型传导的控制机制。
2. 实验
在C面(0001)蓝宝石衬底上,采用MOCVD在875℃下生长了非故意掺杂(UID) β-Ga2O3薄膜。UID样品意味着Ga2O3外延层在外延生长过程中没有被任何掺杂源掺杂。UID β-Ga2O3外延层的厚度约为200 nm。以三乙基镓(TEGa)和高纯度氧(O2, 99.999%)分别作为镓和氧的前驱体。TEGa和O2的流速分别为100 sccm和500 sccm,生长压力为15 托。通过高阻抗计(Hiresta-UX MCP-HT800)测量,UID外延层表现出几乎绝缘和高电阻1014Ω。采用“E220HP”离子注入系统对β-Ga2O3薄膜进行了磷离子注入。该系统产生高达200 keV的高能光束,所产生的离子来自所提供的源。在注入工艺中,相对于光束法线方向的入射角设置为7°,在室温下进行注入。磷离子以2.5×1012 cm-2~ 1.6×1015 cm-2的不同的剂量,以40、50、100 keV的离子能量注入到β-Ga2O3薄膜中。此外,利用多种离子能量,加上不同的剂量,以获得具有平台浓度的均匀表现。
离子注入的性质导致注入区近表面区域磷离子密度降低。为了解决这个问题,使用具有多种能量的离子可以确保及时在进表面区域也可以保持高磷离子浓度。随后,(P) 磷离子注入的β-Ga2O3在1000℃的N2环境中使用快速热退火系统被激活1分钟。为了评估电学性能,将厚度为20/100 nm的Ni/Au金属沉积在被注入的β-Ga2O3外延层上。然后,这些样品在600℃的N2环境中进行1分钟的快速热退火处理,为霍尔测量做准备。
利用SRIM模拟优化了磷离子注入的剂量、深度、能量和浓度。此外,将部分离子剂量与二次离子质谱(SIMS)的实验数据进行了比较,验证了模拟的准确性。使用SRIM软件计算的磷离子浓度(原子/cm3)通过离子数(原子/cm)乘以施加的剂量(原子/cm2)来确定。为了测量RTA处理后β-Ga2O3中Si离子的深度和浓度,使用配有15 kV铯(Cs) 表面离子化源的"Cameca IMS 7F″SIMS仪器对Ga、O、Al、Si和C等元素进行了深度剖面分析。
对于电阻率和霍尔效应测量,我们使用了来自Nanometrics公司的HL5500PC和HL5580高电阻率缓冲放大器/电流源模块,磁场强度为0.5 T。为了进一步检查UID和Si离子注入样品中元素的组成和化学键,激活前后,Ga 2p, Ga 3p, Si 2p和O 1s等核心水平通过XPS进行鉴定。所有的峰都用结合能(B.E.)进行了校准。
3. 模拟
3.1. 第一性原则
在E220HP离子注入系统上进行了范围为2.5×1012 cm -2 至1.6×1015 cm -2的磷离子注入,离子能量分别为40、50和100 keV。在这种情况下,对掺杂离子浓度增加导致强p型半导体直接可以理解的。然而,我们的聚焦在于检查离子状态或掺杂离子的取代原子位置对p型半导体形成的影响。β-Ga2O3的近带隙带结构对p型β-Ga2O3特别重要,因为它们涉及布里渊区(BZ) Γ-point附近的费米能级和价带态,这些带态被受体占据。我们已经开发了将取代的(P) 磷或(P) 磷离子缺陷纳入β-Ga2O3晶格的现实模型,包括Ga8O12(空间群:12 C2/m), Ga8O11PO和Ga7O12PGa,它们代表β-Ga2O3中O和Ga位点上取代的β-Ga2O3和P,如图1所示。值得注意的是,磷(P)的电子构型是[Ne] 3s2 3p3。就电子构型而言,P+2离子与Al(Ga)是等电子的,在3s2 3p1(4s2 4p1)轨道上具有三个等效的外电子。P+3离子与Mg是等电子的,在3s2轨道中有两个等效的外电子。五配位亚磷可能存在于PCl5或P2O5中。缺陷形成能量Ed被定义为具有和不具有缺陷的超晶胞之间的能量差,由下式给出

式中Edefect和Etotal分别为存在和不存在点缺陷的超晶胞的总能量;ni和μi分别为β-Ga2O3第i组分的原子数和化学势。其中μd为β-Ga2O3中取代缺陷或(P) 磷原子的化学势。第一性原理密度泛函理论(DFT)计算使用剑桥序列进行。

图1所示。本研究考虑的Ga8O12(a)、Ga8O11PO(b)和Ga7O12PGa(c)构型模型的球棒结构表示。原子由球体表示:Ga(棕色,大),O(红色,小)和P(亮紫色,中)。(对于本图图例中对颜色的参考解释,请读者参考本文的Web版本。)
总能量封装 (CASTEP)[28,29]。在Perdew-Burke-Ernzerhof (PBE)交换相关泛函[30]的广义梯度近似(GGA中,利用投影增强波(PAW)伪势描述了Ga、O和P的价电子。在第一个BZ中,使用2 ×8 ×4 Monkhorst-Pack网格生成的16个不可约k点进行互反空间积分。能量截止和能量收敛分别设置为450 eV和1.0×10-5 eV/原子。价电子的电子构型为Ga:3d104s24p1,O:2s22p4和P:3s23p3。Ga、O和P的化学势分别由体Ga(空间群:64 Cmca)气体O2(空间群:123 P4/mmm)和体P(空间群:2P1)的原子总能量确定。
表1给出了存在和不存在点缺陷时β-Ga2O3的超晶胞总能和缺陷形成能。结果表明,β-Ga2O3中O位P的中性取代能最低,为7.44 eV,因此最容易形成PO取代缺陷。这些发现与之前的DFT研究一致,报告了PO取代的相似能量值,范围为7.5±0.3eV[31]。我们还观察到,随着β-Ga2O3中O位取代的P离子氧化数的增加,形成能降低到2.42eV,导致缺陷形成的倾向增加。
Ga8O12、Ga8O11PO、Ga8O11PO2+、Ga8O11PO3+和Ga8O11PO5+模型的电子能带结构可以通过第一个BZ中Γ-、N-和x点最小导带的相对位置来确定,如图2所示。Ga8O12的能带结构分析表明,在Γ-point处存在1.98eV的直接带隙。值得注意的是,这个值对应于众所周知的DFT计算低估带隙的趋势。然而,它与其他DFT结果一致,报告了1.98 eV[32]的带隙。费米能量Ef是与PO氧化数x有关的二次方程,表明二次衰减函数Ef =0.1067x2 –0.9741x + 4.3269(0≤x≤5)与费米能量拟合,相关系数为0.9907。PO、PO2+、PO3+或PO5+杂质的引入导致空穴能级的形成,空穴能级随后被填充,导致费米能级的降低。这种现象是由于p型半导体中的主要载流子是空穴,而费米能级的向下移动有利于空穴浓度和迁移率的增加。在PGa、PGa2+、PGa3+、PGa5+杂质的情况下也会出现同样的现象。Ga7O12PGa、Ga7O12PGa2+、Ga7O12PGa3+和Ga7O12PGa5+模型的电子能带结构如图3所示。费米能量与PGa氧化数g的二次函数为Ef =0.1775g2–1.5171g + 5.6190 (0 ≤g ≤5), 相关系数为0.9863。PGa , PGa2+, PGa3+,或PGa5+杂质诱导价带受主能级的产生,随后被空穴占据,从而导致费米能级的二次衰减函数。这种现象源于p型半导体中空穴载流子作为主要载流子的普遍存在,费米能级的向下位移有利于空穴浓度和迁移率的增强。

表1 通过计算元素成分Ga、O、P和合金Ga12O8的体化学势和缺陷形成能,总结了具有代表性的模型及其相应的材料性能。此外,还提供了二次函数中费米能量的计算和拟合。

图2所示。Ga8O12、Ga8O11PO、Ga8O11PO2+、Ga8O11PO3+和Ga8O11PO5+的能带结构和原子投影密度。虚线是费米能级。
3.2. 离子注入的SRIM模拟
为了实现(P) 磷的均匀杂质分布,本研究采用SRIM模拟离子注入参数。设计了低、中、高三种不同的剂量。低剂量包括使用浓度为1.6✕1013、1✕1012和2.5✕1012原子/cm2的(P) 磷离子,注入能量分别为100、50和40 keV。使用的中间剂量浓度分别为1.6✕1014、1✕1013和2.5✕1013原子/cm2的(P) 磷离子在相同的注入能量下运行。高剂量使用浓度为1.6✕1015、1✕1014和2.5✕1014原子/cm2的(P) 磷离子,分别使用100、50和40 keV注入能量。(P) 磷的模拟分布低、中、高剂量如图4所示。这些剂量对应的浓度分别为2✕1018、2✕1019和2✕1020 原子/cm3。在相对较窄的范围内(浓度>1✕1015原子/cm3),低、中、高剂量的箱形分布分别约为170 nm、175 nm和180 nm。值得注意的是,这些范围非常相似,主要是由于相同的注入能量。

图3所示。Ga7O12PGa、Ga7O12PGa2+、Ga7O12PGa3+和Ga7O12PGa5+的能带结构和原子投影密度。虚线是费米能级。
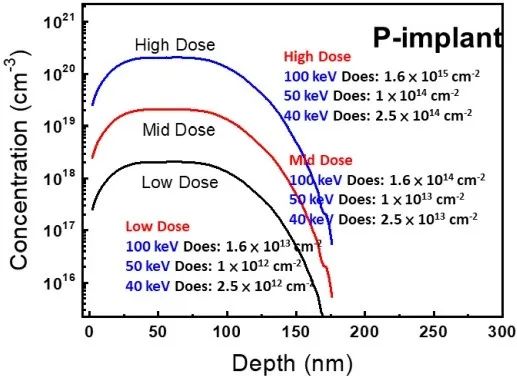
图4所示。采用100、50和40 keV注入能量,用SRIM模拟低、中、高剂量磷离子剂量范围的深度剖面。
如图2虚线所示,上述样品的厚度基本相同,均在175 nm左右。低剂量的(P) 磷分布在外延层内非常均匀,测量值约为2✕1018 cm−3,如图5(a)所示。对于中剂量和高剂量的样品,磷的最大分布分别达到2✕1019和2✕1020 cm−3左右,如图5(b)和(c)所示。值得注意的是,在中剂量和高剂量的样品中观察到(P) 磷扩散到蓝宝石衬底中。此外,与低剂量相比,中剂量和高剂量的样品在Ga2O3外延层中的Al扩散更为明显。这种增强的扩散可能是由于中、高剂量对外延层造成了损伤,导致(P) 磷和Al在1000℃(P) 磷活化工艺中发生了互扩散,互扩散效应也使Ga2O3外延层与蓝宝石基底交界处的(P) 磷浓度降低。值得注意的是,在硅离子注入深度剖面中也观察到界面附近显著的Al扩散,正如其他研究人员所报道的那样[33]。这是一个关键的方面,值得在未来的研究中进一步研究。然而,重要的是要强调,低、中、高剂量所达到的最高浓度分别为2✕1018、2✕1019和2✕1020 cm−3。这些浓度与SRIM模拟的预测非常吻合,表明不仅在深度上,而且在(P) 磷浓度上都非常吻合。
当(P) 磷被注入到Ga2O3外延层中时,确定这些被注入的Ga2O3外延层是否呈现p型或n型特征是至关重要的。紫外线光电子能谱(UPS)是一种被广泛接受的方法,用于研究外延层的价带特性,为带隙内状态的存在提供了有价值的见解[34-36]。当在价带附近(即最低结合能)以高分辨率使用时,UPS可以直接检测到带隙下部的状态的存在,这些状态负责赋予p型特征。
本研究采用XPS法对低、中、高剂量活化(P) 磷注入Ga2O3外延层进行了测定。如图6所示,观察到带隙下半部分的态数量与p型特性之间存在明显的相关性。具体来说,对于这三个样品,发现价带附近的费米能级(EF)对应低、中、高磷离子注入量分别为3.82 eV、1.99 eV和1.84 eV。相应的能带隙如图6所示。显然,低剂量注入的Ga2O3在(P) 磷浓度为2 ×1018 cm-3时仍表现出n型特性。相反,在中、高剂量注入Ga2O3的情况下,价带边缘外推表明EF位于本征能级(Ei)以下,证实了p型行为。随着(P) 磷浓度的增加,EF向价带最大值(EV)移动。
最关键的方面是评估低、中、高剂量磷注入Ga2O3外延层在1000℃退火1分钟后的电学性能。测量了Ni/Au与离子注入Ga2O3外延层之间形成的电接触电流(I-V)的函数。有趣的是,我们观察到低剂量注入的Ga2O3外延层仍然具有高电阻,并且没有获得I-V特性。相比,在中、高剂量Ga2O3外延层下,Ni/Au触点的I-V特性表现出欧姆接触行为,如图7所示。图7的插图提供了测量设置的视觉表示。Ni/Au接触的电阻分别为1.75✕105和7.27✕104Ω,分别对应中剂量和高剂量注入的氧化镓。

图5所示。用(P) 磷离子剂量(a)低、(b)中、(c)高的SIMS测量深度剖面。虚线显示了外延层和衬底的界面。

图6所示。(a)低、(b)中、(c)高剂量Ga2O3的UPS光谱。(a)、(b)和(c)的插入图显示了掺杂Ga2O3带隙中的EF位置。
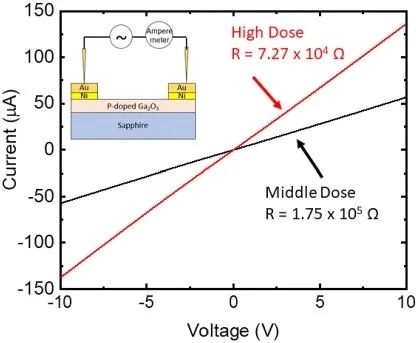
图7所示。Ni/Au和中、高剂量注入Ga2O3外延层的I-V依赖性。插图显示了测量的设置。

表2 离子注入后Ga2O3外延层电学特性。
由于观察到Ni/Au和Ga2O3之间的欧姆接触行为,使用Van der Pauw Hall测量进一步分析样品以确定其导电类型和相对电学性能。所得结果如表2所示。很明显,低剂量注入的Ga2O3外延层几乎成为绝缘体,由于极高的电阻率,无法获得有意义的电性能。UPS分析显示,低剂量注入后存在深度缺陷。虽然SIMS测得的(P) 磷浓度为2✕1018 cm-3,这些杂质似乎在补偿原生氧空位。即便如此,它仍然呈现n型特征,如UPS验证所示(如图6所示)。当注入剂量增加到2✕1019 cm-3时, Ga2O3变为p型,浓度为1.612✕1018 cm-3,由霍尔测量证实。Ga2O3外延层的电阻率和空穴迁移率分别约为9.699 Ωcm和0.399 cm2/V-s。UPS分析也表明了Ga2O3外延层的p型性质。对于高磷注入剂量的样品,它们仍然表现出p型行为,与UPS结果一致。但是,空穴浓度下降到6.428✕1017 cm-3。Ga2O3外延层的电阻率和空穴迁移率分别约为6.439 Ωcm和1.51 cm2/V-s。较低的浓度可能是由于退火前Ga2O3外延层中晶格破坏严重所致。这种损伤增加了磷-铝在外延层与蓝宝石衬底界面处扩散的可能性。由于蓝宝石衬底中扩散的(P)磷较多,而衬底中扩散的Al较多,导致快速热退火工艺后空穴浓度较低。
4. 结论
本研究通过改变剂量离子和能量参数来评价(P) 磷离子注入对β-Ga2O3外延层的影响。在蓝宝石衬底上生长高质量(201)β-Ga2O3外延层,并对其进行了低、中、高剂量的磷离子注入。不同的(P) 磷离子以100、50和40 keV的能量注入外延层。激活工艺后,通过SIMS测量,注入的β-Ga2O3外延层中的磷离子浓度在低、中、高剂量下分别为2✕1018、2✕1019和2✕1020 cm-3。通过UPS测量,确定只有中、高剂量注入的β-Ga2O3外延层的EF位于Ei和EV之间。EF值分别为1.99 eV和1.84 eV。对霍尔测量得到的中、高剂量磷离子注入样品的空穴参数进行了比较,并与理论解释进行了讨论。结果表明,中剂量和高剂量注入样品的电学参数有显著改善。此外,还观察到费米能量与磷离子的氧化数呈二次方程关系。当P离子在β-Ga2O3中的O位(Ga位)被取代时,P离子的氧化数较高,导致形成能较低,达到2.42 eV (- 2.71 eV),表明缺陷形成的可能性增加。
原文链接
https://doi.org/10.1016/j.mtadv.2023.100436


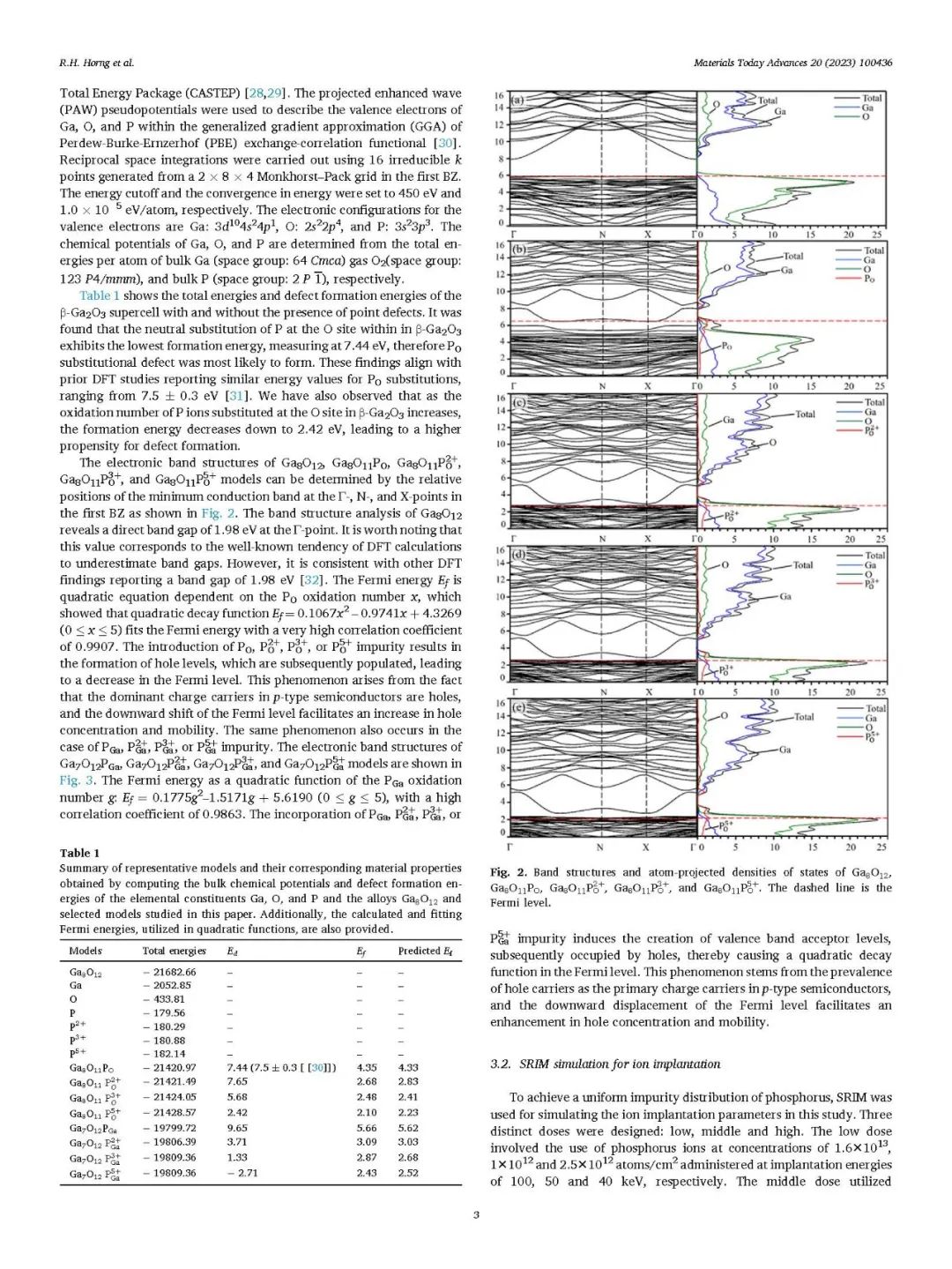
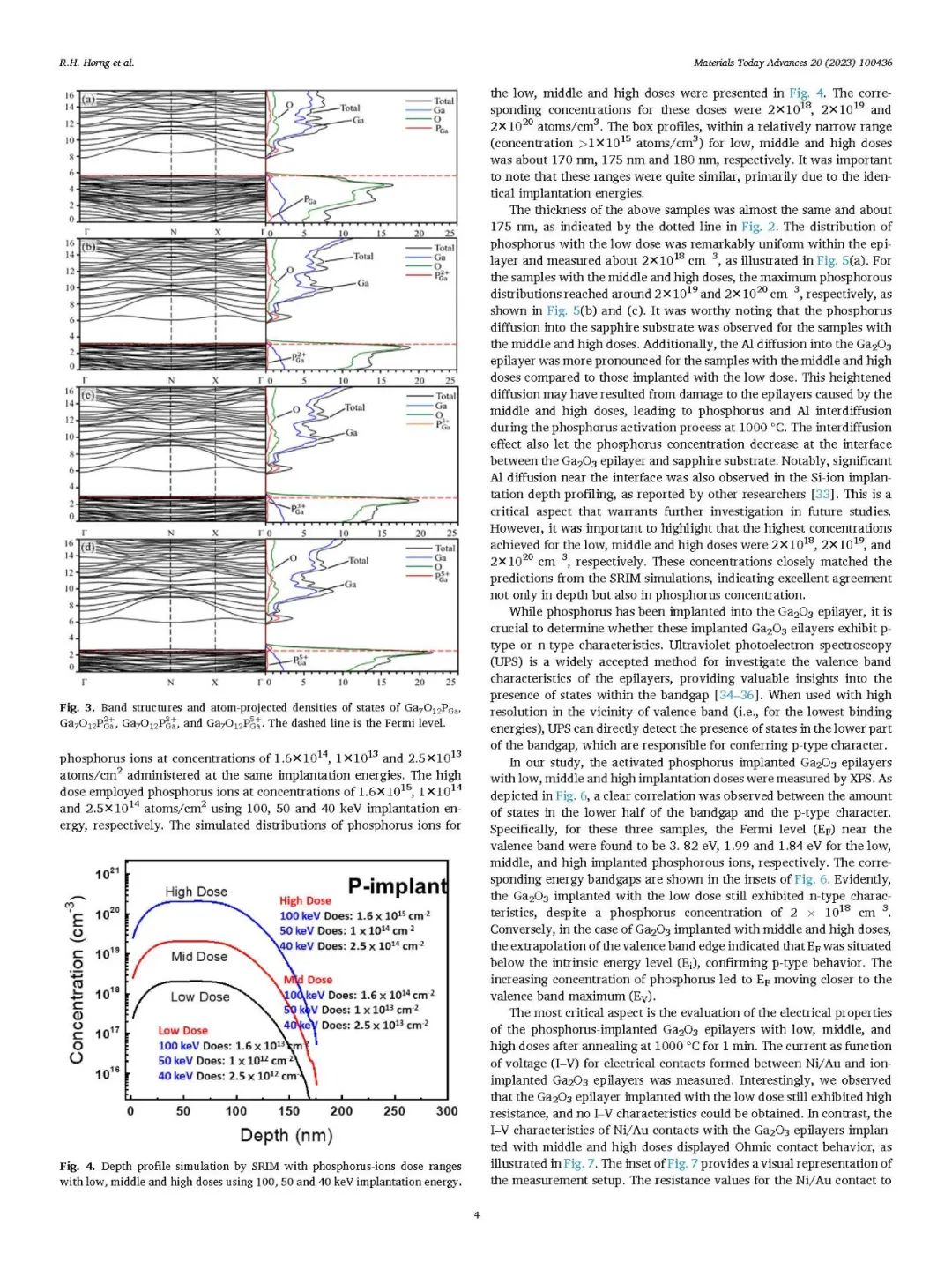
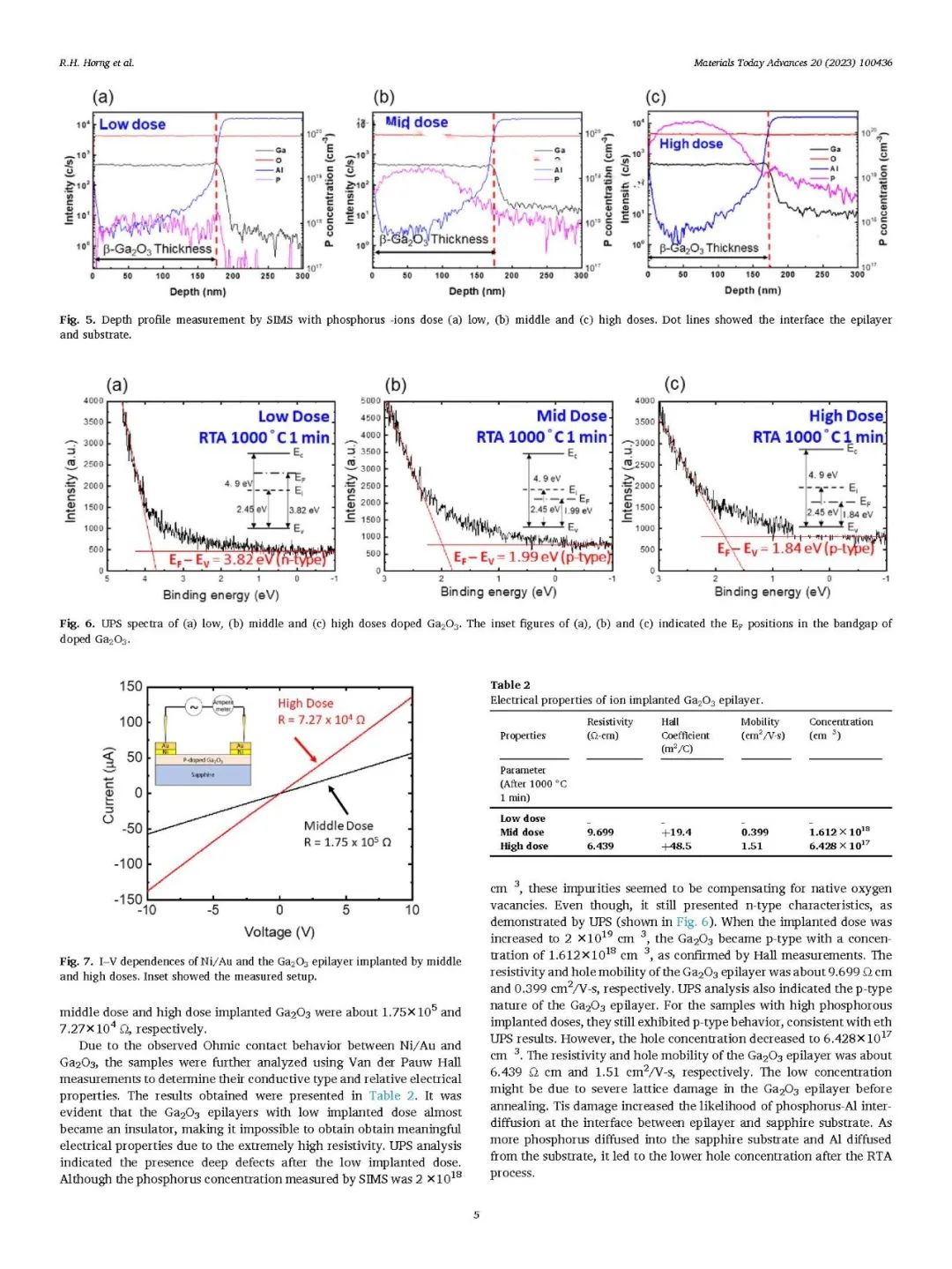


本文转载自《亚洲氧化镓联盟》公众号
