西电郝跃院士、马晓华教授团队---3kV 全垂直 β-Ga₂O₃ 肖特基二极管研究
近期,由西安电子科技大学的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 3 kV fully vertical β-Ga2O3 junction termination extension Schottky barrier diode with sputtered p-GaN(3 kV 全垂直 β-Ga2O3 结终端扩展肖特基势垒二极管与溅射 p-GaN)的文章。
1. 项目支持
该项研究得到了国家自然科学基金(Grant No. 62474135、62104184、62234009、62090014 和 62404165)、中国博士后创新人才支持计划(Grant No. BX20200262)、中国博士后科学基金(Grant No. 2021M692499 和 2023M732730)、中国博士后科学基金特别资助项目(Grant No. GZB20230557)以及陕西省自然科学基础研究计划(Grant No. 2024JC-YBQN-0611)的支持。
2. 主要内容
研究团队制备了一种全垂直 p-GaN/n-Ga2O3 JTE-SBD,并系统研究其电学性能。实验结果表明,该器件在 0.8V 的导通电压(Von)下,具有 6.15 mΩ·cm2 的特定导通电阻(Ron,sp),3 kV 的击穿电压(BV),以及 1.46 GW/cm2 的巴利加优值。此外,I-V-T 测试表明,该器件的反向泄漏电流机制在不同偏压下由 Poole–Frenkel 效应(PF)向可变范围跳跃导电机制(VRH)过渡,揭示了 p-GaN 层对电场调控的作用。
3. 实验细节
(1) 结构与制备工艺
采用 EFG 法生长 650 μm 厚 n+-Ga2O3(ND:4.5×1018 cm-3);
采用 HVPE 法制备 10 μm 厚 n--Ga2O3(ND:2×1016 cm-3)。
采用溅射方法沉积 500 nm 厚的 p-GaN,溅射功率 200W。
在 N2 气氛中进行 750°C 退火 10 分钟,以激活 Mg 掺杂。
选择性蚀刻 p-GaN 以暴露肖特基接触区域。
阳极溅射 Ni/Au(45/400 nm)。
阴极溅射 Ti/Al/Ni/Au(20/160/55/45 nm)。
(2)测试与分析
在 1 MHz 频率下测量电容-电压(C-V)特性,并通过 1/C2-V 曲线提取内建电势(Vbi,0)。
计算得到 JTE-SBD 的肖特基势垒高度(qΦb)为 1.113 eV,相比参考 SBD(Ref-SBD)的 1.011 eV 略高。
导通电压 Von = 0.8V,开/关电流比(Ion/Ioff)> 108。
由于阳极边缘 p-n 结的屏蔽效应,Ron,sp 从 5.51 mΩ·cm2 上升至 6.15 mΩ·cm2。
使用 Silvaco 仿真,发现 JTE 结构使肖特基接触边缘的峰值电场从 8 MV/cm 降低至 6 MV/cm,有效抑制了局部击穿。
在 50°C 至 250°C 之间测量 I-V 特性,发现 Ron,sp 随温度上升线性增加,每升高 1°C,Ron,sp 增加 0.032 mΩ·cm2。
4. 总结
研究团队提出采用溅射 p-GaN 制备全垂直 p-GaN/n-Ga2O3 JTE-SBD。该 JTE-SBD 实现了 3 kV 的 BV 和 1.46 GW/cm2 的 BFOM。进行了 I-V-T 测试以分析 JTE-SBD 的漏电流传输机制。结果表明,在 -1 至 -20 V 范围内,势垒热发射(PF)是主要机制,发射势垒 qφt 为 0.74 eV。在 20 至 200 V 范围内,声子辅助隧穿(VRH)成为主要机制。
5. 实验图示
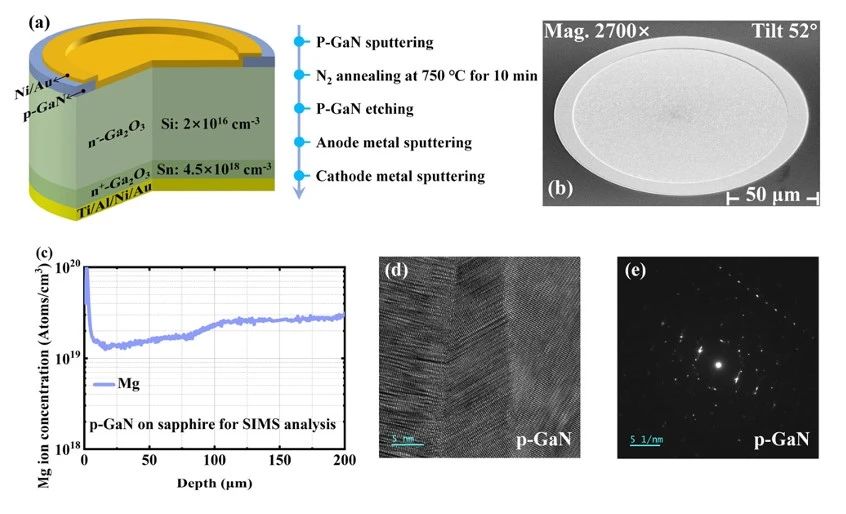
图 1. (a) p-GaN/n-Ga2O3 JTE-SBD 的结构示意图和制造工艺图。(b) 以 52° 的倾斜角和 2700 倍的放大率拍摄的 JTE-SBD 扫描电镜图像。(c) 对蓝宝石衬底上溅射的 p-GaN 中镁元素分布的 SIMS 分析。(d) 5 nm 尺度的溅射 p-GaN HRTEM 分析。(e) 对溅射 p-GaN 的 SAED 测试。
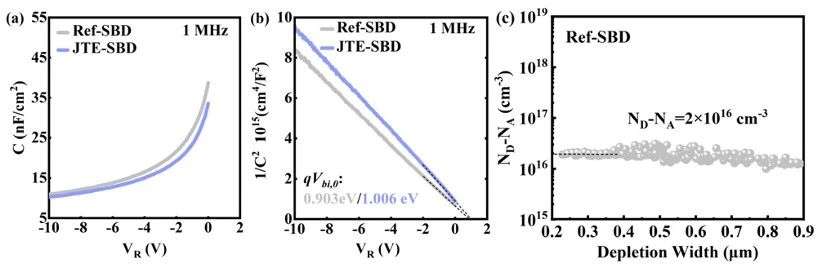
图 2. (a) p-GaN/n-Ga2O3 JTE-SBD 的 C-V 和 (b) 1/C2-V 特性。(c) 从 C-V 测量中提取的 n--Ga2O3 漂移层 ND-NA。
DOI:
doi.org/10.1063/5.0243637
本文转发自《亚洲氧化镓联盟》订阅号
