西安电子科技大学郝跃院士、马晓华教授团队---探究 β-Ga₂O₃ SBD 在正向电应力下的退化机制
由西安电子科技大学的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 Forward bias stress-induced degradation mechanism in β-Ga2O3 SBDs: A trap-centric perspective(正向偏压应力诱导的 β-Ga2O3 SBD 降解机制: 以陷阱为中心的视角)的文章。该篇文章为编辑精选(Editor’s Pick)文章。
1. 项目支持
该项研究得到了中国国家重点研发计划(Grant No. 2023YFB3611902)、国家自然科学基金(Grant Nos. 62104180、U2241220 和 62421005)、陕西省自然科学基础研究计划(Grant No. 2023-JCQN-0669)以及国家辐射应用创新中心基金(Grant No. KFZC2022020401)的支持。
2. 背景
β-Ga2O3 由于其宽禁带(4.5~4.9 eV)和高击穿场强(~8 MV/cm)等优异特性,已成为包括肖特基势垒二极管(SBD)在内的大功率电子器件的理想材料。然而,SBD 在正向偏压应力作用下容易发生降解,影响其长期可靠性。本研究旨在探讨 FBS 诱导的 β-Ga2O3 SBDs 退化机制,重点关注与陷阱(trap)相关的物理过程。
3. 文章摘要
该研究从缺陷演变的角度探讨了恒定正向电应力对β-氧化镓(β-Ga2O3)肖特基势垒二极管(SBD)的影响。长时间的应力显著增加了反向漏电流密度(JR)和小偏压下的正向电流密度(JF),并降低了开启电压(Von)。温度依赖的电流 - 电压(I-V-T)分析表明,新鲜和受应力的 SBD 的反向漏电流均由波尔 - 弗伦克尔(PF)发射主导,而正向电流传输机制在受应力后从热电子发射(TE)转变为陷阱辅助隧穿(TAT)。深能级瞬态谱(DLTS)结果确定了β-Ga2O3 漂移层内一个本征陷阱 E2*(Ec - 0.75 eV),这很可能是与镓空位相关的陷阱。该能级与 PF 障壁的一致性证明了该陷阱浓度的增加是 JR 增加的主要原因。空间分布特征表明,金属 - 半导体界面附近陷阱浓度的增加远大于体内的增加,这确立了该陷阱与小偏压下的 JF 和 Von 之间的关联。这些发现突显了陷阱演变在 SBD 电应力下性能退化中的关键作用。
4. 创新点
•通过系统性的实验分析,首次明确了 β-Ga2O3 SBD 在 FBS 作用下的陷阱演变机制。
•采用 DLTS 技术检测到特定陷阱能级,揭示了正向偏压应力诱导的界面态和体缺陷变化。
•提出了一个基于陷阱充电和释放的退化模型,解释了 β-Ga2O3 SBD 退化的关键物理过程。
•研究结果可为提高 β-Ga2O3 SBDs 的长期稳定性和可靠性提供指导。
5. 结论
该研究探讨了 β-Ga2O3 SBD 在正向电应力下的退化机制。随着应力时间的增加,反向电流和小偏压下的正向电流均增加,开启电压降低。通过深入研究导电机制和陷阱特性(采用 DLTS 测量),我们发现与 EC-0.75 eV 处的 VGa 相关的陷阱 E2* 增加,导致以 PF 发射机制为主的反向电流增加。靠近金属-半导体界面处陷阱浓度的更显著增加,有效降低了等效肖特基势垒高度,从而增加了小偏压下的正向电流,并导致开启电压的负向漂移。有趣的是,观察到了从界面延伸的准指数陷阱分布,并将其与 β-Ga2O3 SBD 电学性能的退化相关联。本研究建立了陷阱浓度、陷阱空间分布与器件性能随应力时间变化的关系,为提高 β-Ga2O3 SBD 的可靠性提供了有价值的见解。
6. 图文内容
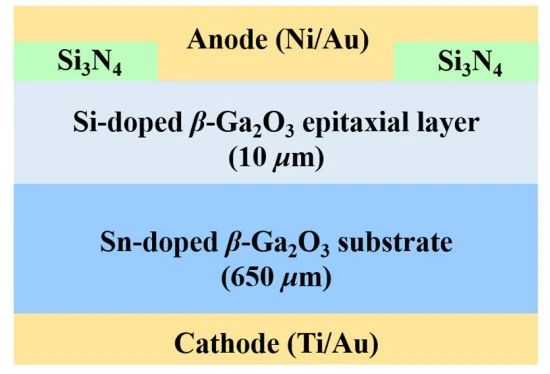
图 1. 场板结构 β-Ga2O3 SBD 的横截面示意图。

图 2. (a) 正向偏压应力期间的半对数缩放 J-V 图和 (b) 线性缩放 J-V 图。插图:电流密度为 1 A/cm2 时 J-V 特性的部分放大。(c) 以 1 MHz 频率测量的 β-Ga2O3 SBD 的 C-V 特性。插图: 器件在不同应力时间下提取的净载流子浓度与耗尽区深度的关系。
DOI:
doi.org/10.1063/5.0260529
本文转发自《亚洲氧化镓联盟》订阅号
