中山大学在异质外延ε-Ga₂O₃ MOSFET器件研究中取得系列进展
1. 研究进展
超宽禁带半导体氧化镓(Ga₂O₃)以其卓越的材料特性,正成为下一代大功率电子器件的重要候选材料。在众多晶相中,ε相氧化镓(ε-Ga₂O₃)作为第二稳定相,不仅具备异质外延生长质量高、极化效应显著等独特优势,更能有效解决当前β相Ga₂O₃功率器件存在的散热性能不足和衬底成本高昂等关键问题。中山大学卢星副教授、王钢教授课题组在异质外延ε-Ga₂O₃ MOSFET器件研究领域取得系统性突破,从高导热碳化硅衬底应用、大电流器件制备到E/D模反向器单片集成,为发展低成本、高性能氧化镓功率电子器件提供了全新的技术路径。
2. ε-Ga₂O₃:异质外延生长与掺杂技术突破
研究团队基于自主金属有机化学气相沉积(MOCVD)装备和技术,在蓝宝石、硅及4H-SiC衬底上成功实现了纯相ε-Ga₂O₃薄膜的可控制备。高分辨率X射线衍射(HRXRD)分析表明,薄膜仅呈现ε-Ga₂O₃特征的(002)(004)(006)衍射峰,完全不含β相杂峰。针对ε-Ga₂O₃掺杂难题,团队开创性地通过表面电子态调控技术,在ε-Ga₂O₃表面诱导形成类二维电子气,使载流子面密度突破至10¹⁴ cm⁻²量级。基于4英寸蓝宝石衬底制备的ε-Ga₂O₃ MOSFET器件(LGD=20 μm),不仅获得118 mA/mm的最大输出电流IDS,更实现2.85 kV的高击穿电压,创造了异质外延Ga₂O₃功率器件0.29 GW/cm²的功率优值(PFOM)新纪录。相关成果已发表于ISPSD 2024学术会议[1]。
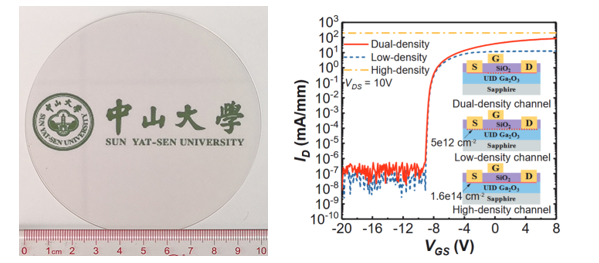
图1 基于自主MOCVD技术在4英寸蓝宝石衬底上生长的ε-Ga₂O₃薄膜的光学图像;具有不同沟道设计的ε-Ga₂O₃ MOSFET 转移特性的仿真结果。
3. 4H-SiC衬底:热管理优化与性能提升
为克服Ga₂O₃功率器件散热瓶颈,团队采用高导热2英寸4H-SiC衬底,成功研制出增强型(E-mode)ε-Ga₂O₃ MOSFET。得益于优异的散热性能,沟道长度2 μm的器件展现出209 mA/mm的大输出电流、2.7 V的高阈值电压、42 mS/mm的大跨导以及超过10⁷的电流开关比,综合性能指标达到国际领先水平。该突破性成果发表于IEEE Electron Device Letters期刊[2]。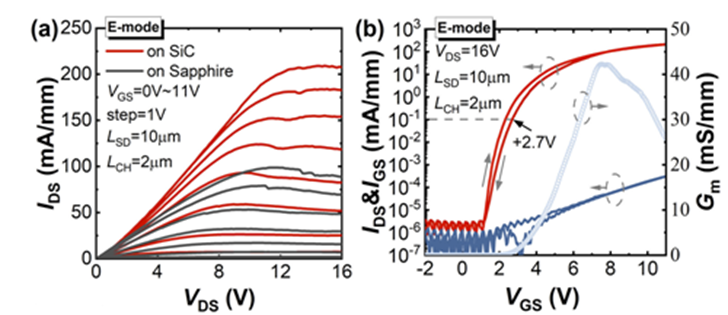
图2 基于4H-SiC衬底和蓝宝石衬底的ε-Ga₂O₃ MOSFET器件性能对比
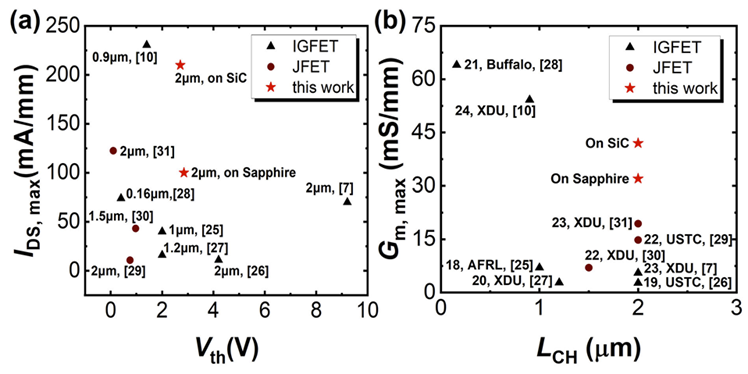
图3 本研究的ε-Ga₂O₃ MOSFET器件与已有文献报道的Ga₂O₃横向晶体管器件性能对比。
4. 大电流器件设计与实现
通过设计多指结构(总栅宽LW=6.24 cm),团队成功开发出大电流输出的ε-Ga₂O₃ E-mode MOSFET器件。在VDS=20 V、VGS=7 V工作条件下,器件最大输出电流高达3.7 A,创下目前横向Ga₂O₃晶体管电流输出能力的最高纪录。此项研究成果已在DRC2025学术会议上发表[3]。
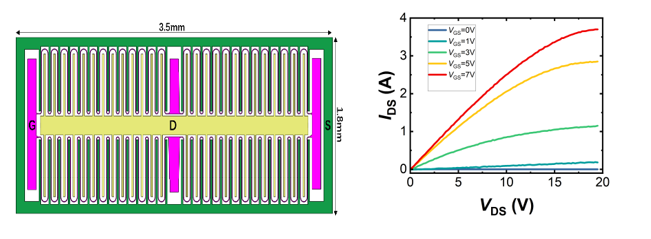
图4:大尺寸ε-Ga₂O₃ MOSFET器件的版图和输出特性。
5. E/D模单片集成与逻辑电路实现
面向功率集成电路(Power IC)发展需求,团队基于自主开发的异质外延ε-Ga₂O₃ MOSFET技术,在蓝宝石衬底上实现了ε-Ga₂O₃增强型/耗尽型(E/D-mode)反向器的单片集成。所构建的反向器表现出8.96 V的逻辑电压摆幅,在9 V供电电压下获得10.4倍的电压增益,充分展现了异质外延ε-Ga₂O₃在超宽禁带功率集成电路领域的巨大应用潜力。该成果已入选ISPSD 2025学术会议[4]。
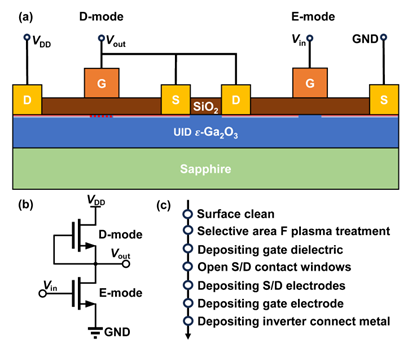
图5:基于异质外延 ε- Ga₂O₃ MOSFET的单片集成 E/D模反向器的结构示意图、电路图及(c)制造工艺流程
6. 研究展望
中山大学研究团队长期致力于氧化镓等新一代宽禁带半导体材料的研发与装备研制,在异质外延ε-Ga₂O₃ MOSFET器件领域取得的系列创新成果,不仅为突破现有技术瓶颈提供了全新思路,更为推动我国在高端功率电子器件领域的自主创新发展奠定了坚实基础。
7. 科研支持
本研究获国家重点研发计划(2024YFE0205300)、国家自然科学基金(62471504)资助,特此致谢中山大学光电材料与技术全国重点实验室和中山大学电子与信息工程实验教学中心的技术支持。
论文列表
[1] Deke Zeng, Shengheng Zhu, Tiecheng Luo, Weiqu Chen, Zimin Chen, Yanli Pei, Gang Wang, and Xing Lu, “Heteroepitaxial epsilon-Ga2O3 MOSFETs on a 4-inch Sapphire Substrate with a Power Figure of Merit of 0.29 GW/cm2,” in 2024 36th International Symposium on Power Semiconductor Devices and ICs (ISPSD), Jun. 2024, pp. 192–195. doi: 10.1109/ISPSD59661.2024.10579602.
[2] Shengheng Zhu, Linxuan Li, Tiecheng Luo, Weiqu Chen, Chenhong Huang, Xifu Chen, Zhanyun Huang, Zimin Chen, Yanli Pei, Gang Wang, and Xing Lu, “Demonstration of High-Current E-Mode MOSFETs Using Heteroepitaxial ε-Ga2O3 on 4H-SiC Substrates,” IEEE Electron Device Lett., vol. 46, no. 5, pp. 721–724, May 2025, doi: 10.1109/LED.2025.3553520.
[3] DRC2025 (尚未见刊)
[4] ISPSD2025(尚未见刊)
本文转发自《亚洲氧化镓联盟》订阅号
