解密器件高温危机:郝跃院士团队解锁氮化镓、金刚石、氧化镓散热终极方案
近日,西安电子科技大学郝跃院士、张进成教授、周弘教授、冯欣副教授团队系统综述宽禁带与超宽禁带器件级热管理技术的最新突破:从 “热从哪来” 到 “怎么降温”,带大家看懂宽禁带半导体的 “退烧指南”。
该综述涵盖从器件内部结构优化(包括版图优化、衬底减薄、高热导率衬底键合与覆层)至外部热增强策略(如倒装芯片封装、微通道主动冷却及瞬态热管理技术)的全链条技术体系。深入探讨了当前技术瓶颈、潜在解决方案及未来发展机遇,旨在突破关键散热技术壁垒,推动宽禁带与超宽禁带半导体的深度产业化进程。

一、先搞懂:WBG/UWBG 为何这么 “怕热”?
在新能源汽车、5G 基站、数据中心的核心设备里,宽禁带(WBG)与超宽禁带(UWBG)半导体正成为 “性能担当”。GaN(氮化镓)器件已实现产业化,2023 年全球市场规模突破 175 亿美元,年增速预计超 22%;Ga₂O₃(氧化镓)等 UWBG 材料更是被视作下一代电力电子的 “潜力股”,在高功率场景中优势显著。
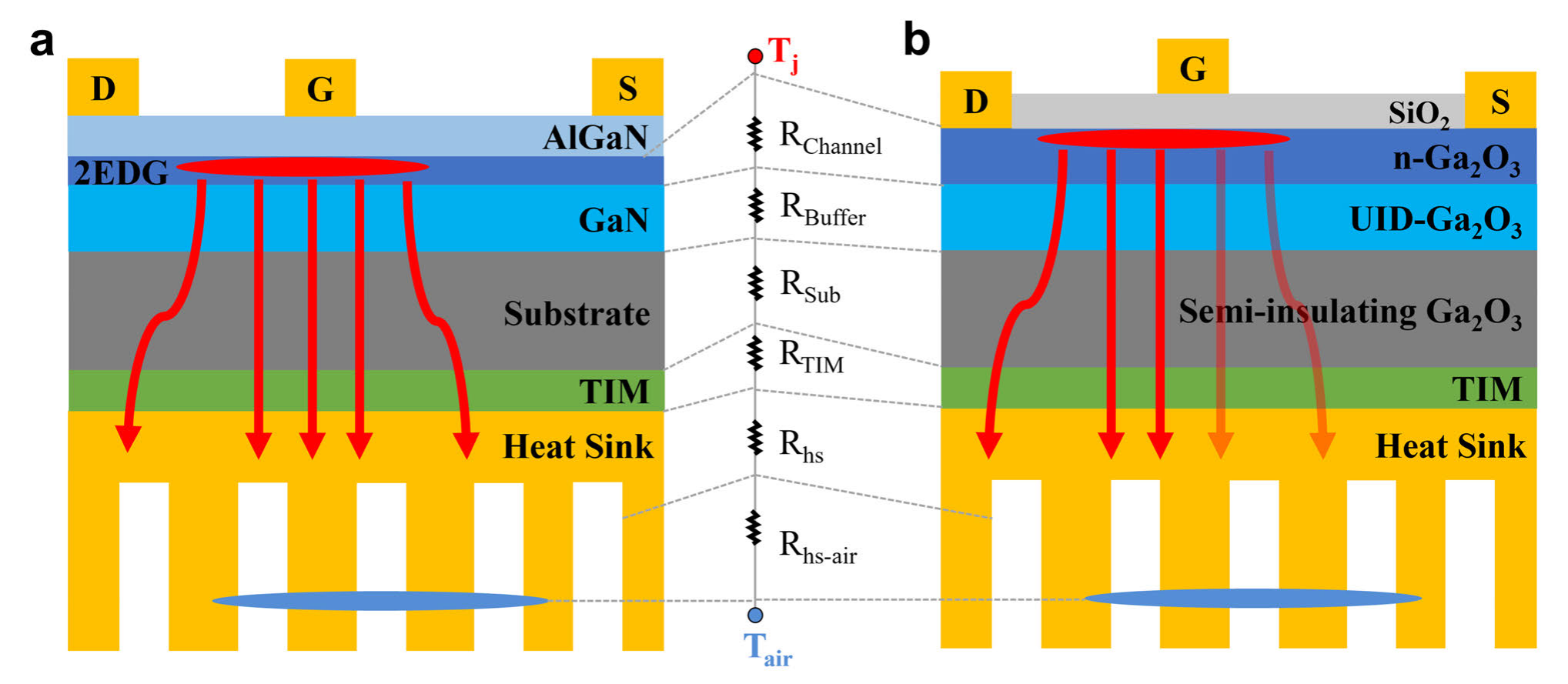
图1:(a)氮化镓HEMT和(b)Ga₂O₃ MOSFET的热耗散通路和等效热阻模型。
但这些 “高能芯片” 有个致命短板 ——怕热。高功率工作时,GaN HEMT 栅极附近热流密度能飙到数十 kW/cm²,局部热点温度骤升;Ga₂O₃本征热导率仅为 GaN 的 1/10,热量散不出去,结温超过 200℃时输出电流直接下降 40mA/mm,严重时甚至会烧毁器件。随着器件向 “更小尺寸、更高功率密度” 发展,散热难题已成为制约 WBG/UWBG 产业化的核心瓶颈。
要解决散热问题,得先摸清 “热源” 和 “热危害” 的规律。综述通过热成像与仿真,清晰呈现了两类核心器件的散热痛点:
1. 热量集中在哪?
GaN HEMT:热量主要聚集在 “栅极靠近漏极” 区域(电场拥挤导致),散热瓶颈是 GaN 与外延衬底间的热边界电阻(TBR) —— 界面处声子传输受阻,热量 “卡” 在中间散不出去。Ga₂O₃ MOSFET:虽然 TBR 小(同质外延工艺优势),但材料本身热导率极低(0.11-0.27 W/cm・K),相当于 “热量在材料里走得极慢”,热阻主要来自自身。
两类器件的热传导路径类似:沟道→缓冲层→衬底→热界面材料(TIM)→散热器→空气。任何一个环节 “堵了”,都会导致热量堆积。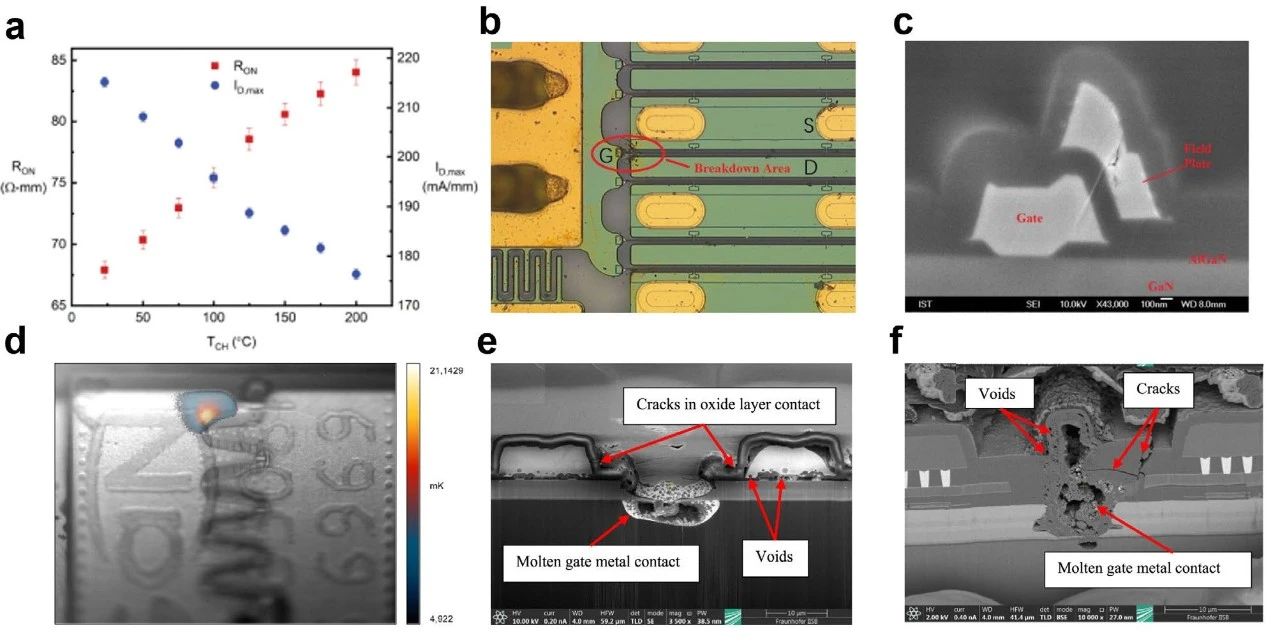 图2:(a)带有β -Ga2O3软沟道MOSFET的I 、 和 随温度变化曲线 。 (b) 氮 化 镓 HEMT(CGH-27015)的击穿面积。(c)热致聚集导致场极板出现裂纹。(d)氮化镓MISHEMT上的热点区域。(e) p-GaN HEMT和(f)氮化镓MIS-HEMT在无箝位电感开关(UIS)测试后的损伤区域。
图2:(a)带有β -Ga2O3软沟道MOSFET的I 、 和 随温度变化曲线 。 (b) 氮 化 镓 HEMT(CGH-27015)的击穿面积。(c)热致聚集导致场极板出现裂纹。(d)氮化镓MISHEMT上的热点区域。(e) p-GaN HEMT和(f)氮化镓MIS-HEMT在无箝位电感开关(UIS)测试后的损伤区域。
2. 过热有啥严重后果?
性能暴跌:Ga₂O₃ MOSFET 结温达 200℃时,最大输出电流(I_Dmax)下降 40mA/mm,导通电阻(R_ON)反而升高,能量损耗骤增;
器件烧毁:GaN HEMT 的二维电子气(2DEG)沟道仅纳米级,局部焦耳热可超过栅极金属熔点,导致栅极破裂、金属层熔化(如图 2 所示);
可靠性下降:65W GaN 充电器这类小型化设备,体积缩小后热流密度更高,长期高温会缩短器件寿命,甚至引发安全风险。
二、五大器件级热管理技术,从 “被动降温” 到 “主动散热”
综述将技术分为 “被动冷却”(靠材料 / 结构导走热量)和 “主动冷却”(靠外力带走热量)两大类,覆盖从器件内部到外部封装的全链条解决方案。每个方案都有清晰的原理、案例和效果数据,我们逐个拆解:
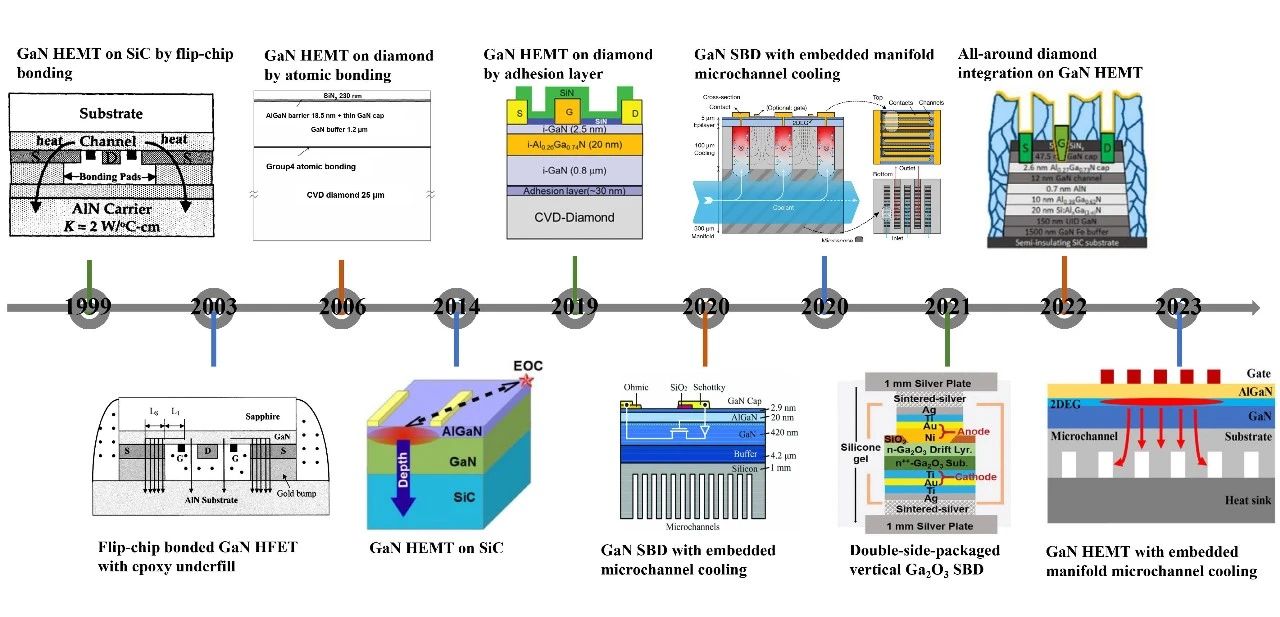
图3:高压结/超高压结热管理技术发展简史
1. 平面结构优化:靠 “布局” 减少积热,简单高效
核心思路:调整器件表面 “多指结构” 的间距,缓解 “热串扰”—— 很多 WBG 射频器件用 “多指结构” 提升功率,但相邻指之间易形成 “热叠加”,中心指温度比边缘高 20℃以上(如图 4 所示)。

图4:(a)通过增加栅极间距对氮化镓HEMT进行等温模拟及热流线分析。(b)在10 W/mm功率下多指氮化镓HEMT的温度分布情况。(c)在10 W/mm功率下,多指氮化镓HEMT中温度差与中心到边缘间距关系示意图。(d)多指氮化镓HEMT的两种布局方式及相关间距参数(e)。(f)不同布局下的温度差模拟及对应温度分布(6.0W/mm工况)(g)。不同应力下(h)金属硅与(i)离子的退化现象。
具体方案:
增大指间距:Manoi 团队将 GaN HEMT 的漏源间距从 30μm 增至 75μm,中心指温度直接降了 7℃,热分布更均匀;
非均匀指间距:Jeong 团队设计 “中间疏、两边密” 的指距布局,平均表面温度降低 20℃,同时缓解了亚阈值摆幅(SS)和导通电流(I_ON)的退化。
优缺点:工艺简单、成本低,适合改良现有多指射频器件,但无法降低器件平均温度,通用性有限 —— 毕竟不是所有器件都有 “多指结构”。
2. 衬底减薄 + 高导热衬底:缩短 “热通路”,提升导热效率
衬底是热量从沟道到散热器的 “主干道”,这一技术从 “减短距离” 和 “拓宽道路” 两方面发力,是目前产业应用最广的方案之一。
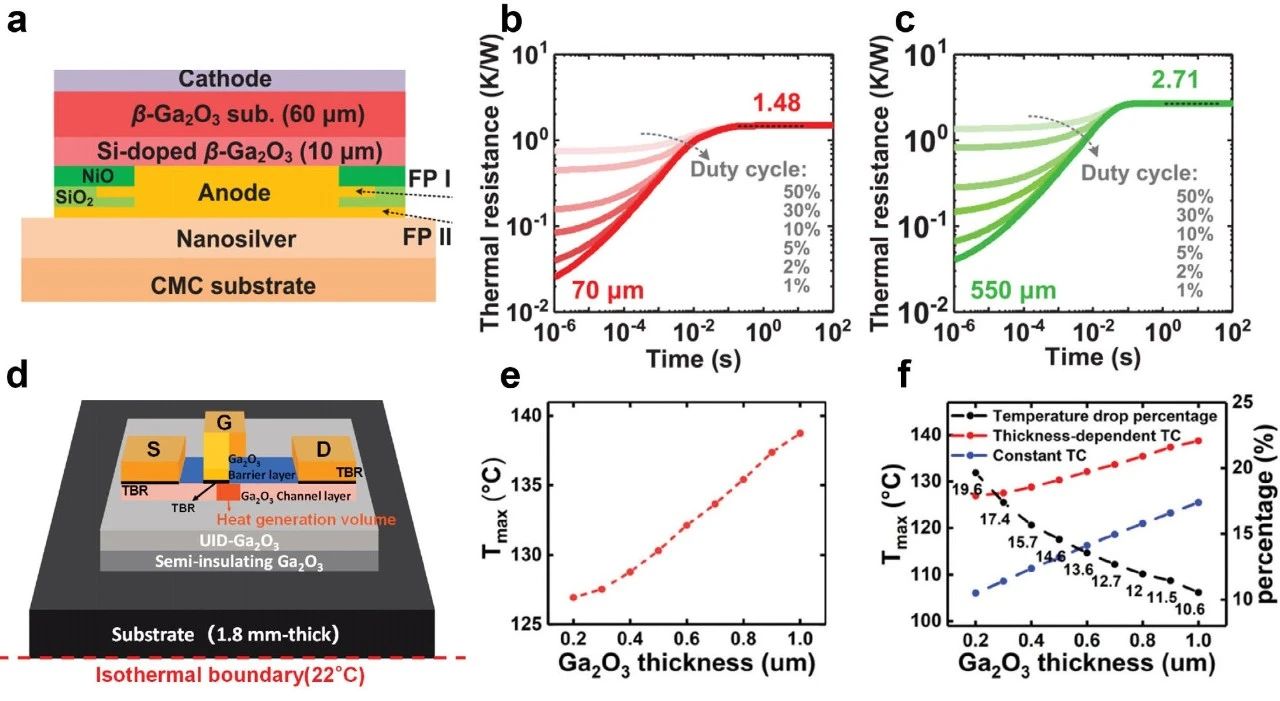
图5:(a)倒装芯片Ga₂O₃ SBD结构示意图。基板厚度分别为(b) 70 μm和(c) 550 μm的Ga₂O₃ SBD随时间变化的热阻曲线
(1)衬底减薄:让热量 “走得更近”
原理:衬底越薄,热量从沟道到衬底背面的距离越短,热阻自然越低。
实测效果:Ga₂O₃ SBD(肖特基势垒二极管)衬底从 550μm 减薄至 70μm,热阻从 2.71 K/W 降至 1.48 K/W,降幅达 45%(如图 5 所示);仿真显示,Ga₂O₃厚度从 0.2μm 增至 1μm 时,相同功率密度下最高温度升高 12℃—— 厚度增加会进一步降低热导率,相当于 “路变窄了”。
注意点:衬底不能无限薄,过薄会导致晶圆易碎,影响后续光刻、键合等工艺,需要在 “散热效果” 和 “机械强度” 间找平衡。
(2)高导热衬底:用 “导热高手” 替代传统衬底
减薄解决了 “距离问题”,但衬底本身的导热能力也很关键。综述对比了四种主流高导热衬底的效果,数据一目了然:


图6。(a)在30 W/mm功率密度下,碳化硅基底上氮化镓HEMT的温度随深度变化曲线。(b)4H-SiC基底上β -Ga2O3 FET的原子力显微镜图像。(c)不同基底下T随输入功率的变化关系。(d)Ga2O3 梅塞夫特结构示意图。(e)单指状(f)六指状及不同基底下Ga2O3 梅塞夫特在5 W/mm下的T 随功率密度变化曲线。(g)采用离子切割技术制备的Ga2O3 SBD基底表面温度图像(输入功率380mW)。(h)不同基底下峰值温度随施加功率变化曲线。(i)温度依赖性I-V特性。
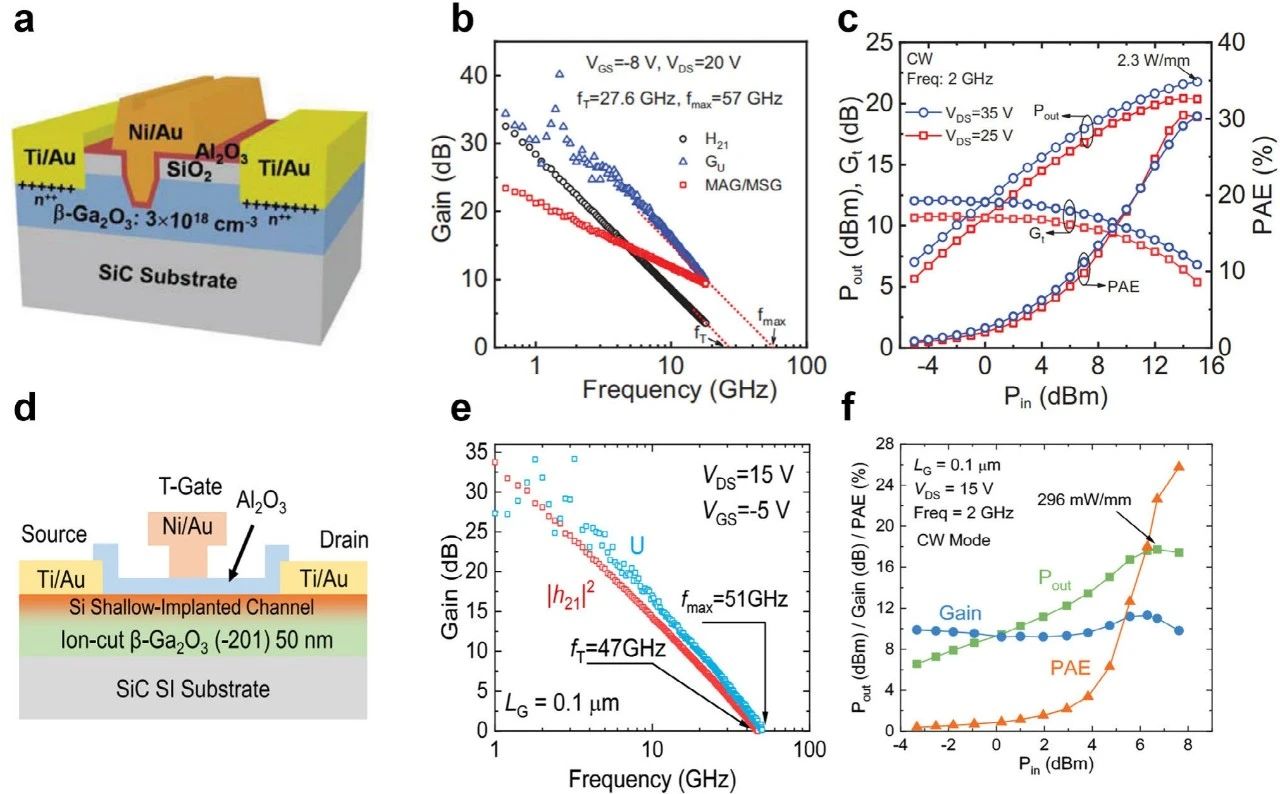
图7。(a)碳化硅基板上β -Ga2O3射频功率场效应晶体管结构示意图。(b)小信号射频特性曲线。(c)大信号AB类工作性能。(d)碳化硅基板上β -Ga2O3射频金属氧化物半导体场效应晶体管结构示意图。(e)小信号射频特性曲线。(f)在2GHz连续波模式下线性度Lg为0.1的大信号性能测试。

图8。(a)基板转移后氮化镓HEMT的输出特性。(b)不同热阻比(TBR)和基板条件下各层氮化镓HEMT在10 W/mm功率下的温升曲线。(c)顶部集成金刚石结构的n极性氮化镓HEMT截面示意图。(d)样品STEM显微图像显示30nm成核层和1nm 3 SiN4层。(e)晶体化学气相沉积法在金刚石基板上制备氮化镓HEMT的示意图。(f) I 减少曲线及(g)温升与功率密度关系图。(h)Si基板上氮化镓HEMT在17.1 W/mm直流输出功率下的稳态热反射图像(左),金刚石基板上氮化镓HEMT在24.2W/mm直流输出功率下的稳态热反射图像(右)。(i)栅极-漏极接触区平均温度变化与直流功率关系曲线。

图9。(a)铜基底上氮化镓HEMT结构示意图。(b)I-V特性曲线。(c)用于对比的红外热成像图。(d)嵌入铜层的氮化镓HEMT结构示意图及对应(e)中的I-V特性曲线。(f)12W/mm功率密度下的热成像图。(g)铂基合金(BAs)上氮化镓HEMT的SEM左图与TEM右图截面对比。(h)两种最佳导热材料(铂基合金与金刚石)的热点温度随加热面积变化关系。(i)施加功率密度时的温升曲线。
产业现状:SiC 衬底技术最成熟,成本相对可控,是目前高功率 GaN 器件的主流选择;金刚石虽散热效果最好,但异质外延工艺复杂、成本高,主要用于高端场景;BAs 是 “潜力股”,但目前还在实验室阶段,大规模制备难度大。
3. 沟道附近热工程:“近距离” 快速导走热量
传统方案靠衬底 “远程导热”,而这一技术直接在 “热源(沟道)旁边” 建散热通道,相当于 “在火场旁边装抽风机”,效率大幅提升。
(1)表面沉积高导热膜:给器件 “盖一层散热片”
在器件表面(靠近沟道处)沉积金刚石、AlN 等高热导材料,既不影响器件电学性能,又能快速导走热量:
GaN HEMT 案例:科研人员在器件表面沉积 50nm 厚的微晶金刚石(MCD)膜,25 W/mm 功率下温度降低 100℃,饱和电流和峰值跨导分别提升 2 倍、1.5 倍(如图 10 所示);
Ga₂O₃ HFET 案例:覆盖纳米晶金刚石(NCD)层后,I_Dmax 从 6.8 mA/mm 飙升至 70 mA/mm,温度降低 40℃。

图10. (a)采用拉曼光谱系统对表面金刚石基氮化镓HEMT进行温度测量的示意图,(b)直流功率密度与最高温度的关系曲线,(c)传输特性对比图。(d)带有NCD热扩散层的β -Ga2 O3高氟3氧2》场效应晶体管(HFET)横截面结构,(e)和(f)分别为采用MOS/β NCD栅极时的直流传输特性,(g)和(h)输出特性对比((i))为功率密度1.5 W/mm时带NCD层的β -Ga2O3高氟氧晶体管热反射图像
(2)全包裹式散热:给器件 “套一层金刚石外壳”
Soman 团队提出 “全金刚石封装 GaN HEMT”—— 用金刚石把器件全方位包裹,360° 导走热量。测试显示,9.5 W/mm 功率下,栅极附近峰值温度降低 100℃,功率密度可达 22.7 W/mm,效果远超 “只在表面沉积金刚石” 的方案(如图 11 所示)。
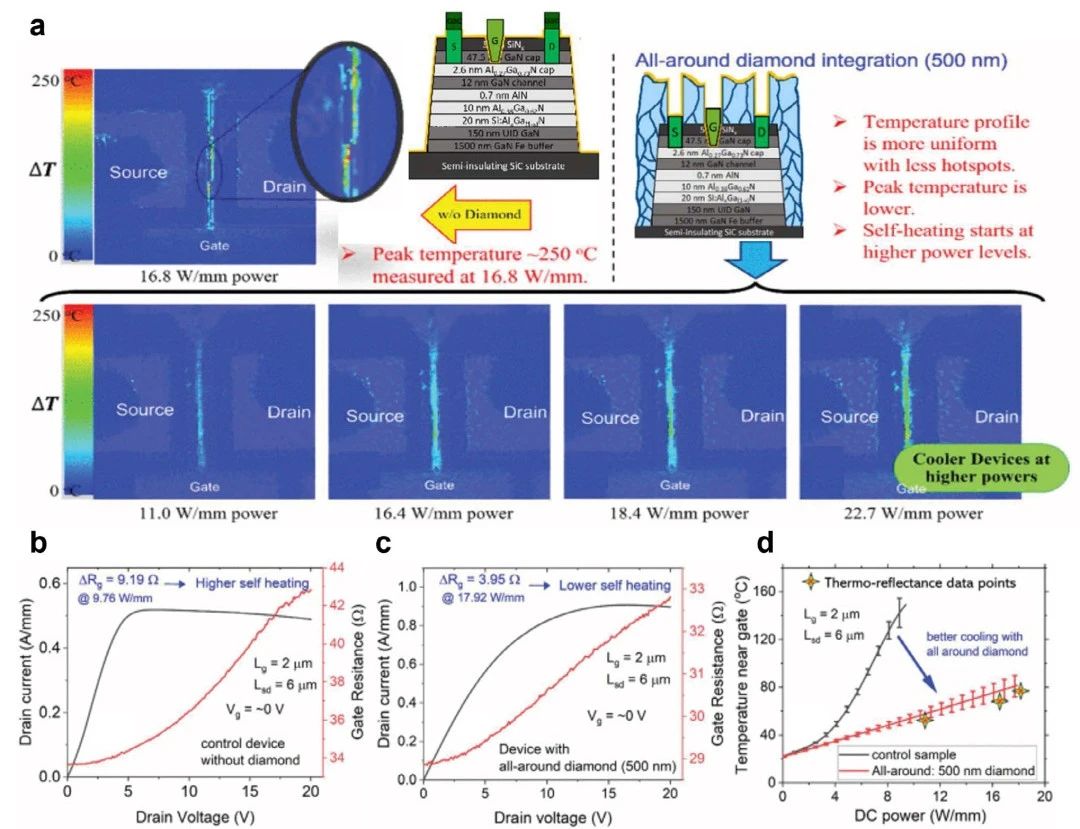
图11:(a)未封装与(b)/(c)I-V特性曲线(分别对应是否封装金刚石)的热反射率图像。(d)直流功率密度与温度关系曲线
4. 倒装芯片 + 双面散热:靠封装 “打通散热双通道”
封装是热量从器件到散热器的 “最后一公里”,这一技术通过 “倒装” 和 “双面导热”,优化了传统封装的散热瓶颈。
(1)倒装芯片封装:让热量 “换条路走”
传统封装中,器件正面朝上,热量要 “穿过芯片” 到背面;倒装封装则把器件 “翻过来”,直接通过凸点连接到高导热载体(如金刚石、SiC),缩短热路径:
Ga₂O₃ MOSFET 案例:倒装到金刚石载体并配合热通孔,结 - 封装热阻降至 7 mm・K/W,表面温度仅升至 60℃(如图 12 所示),比传统封装低 50% 以上;
GaN SBD 案例:结合衬底减薄与倒装封装,浪涌电流从 27A(对照组)提升至 62A—— 浪涌时短时间产热多,倒装结构能快速导走热量,避免器件失效。

图12。(a)采用NCD钝化技术的倒装芯片Ga2O3 MOSFET结构示意图。(b)结构与封装热阻对比。(c)不同器件结构的温度差随时间变化曲线。(d)CAVET器件结构示意图。(e)底部冷却与(f)双侧冷却的CAVET器件仿真结果。(g)相对温度随直流功率密度变化关系图。(h)不同冷却方案下的最大温度与耗散功率密度关系图。(i)双侧冷却Ga2O3 MOSFET结构示意图。
(2)双面散热:“正面 + 背面” 同时降温
针对 Ga₂O₃这类热导率低的器件,单面散热不够,科研人员提出 “双面散热” 方案:在器件正面(沟道附近)和背面(衬底)都加散热器,相当于 “前后同时抽热”。
仿真与实测效果:
垂直 Ga₂O₃ MOSFET 用双面散热后,最大通道温度比仅底部散热降低一半以上;
相同结温限制下,功率密度提升 5 倍(如图 12 所示);
实际应用中,Ga₂O₃ SBD 用 “1mm 银板 + 纳米银烧结” 做双面封装,热阻从 1.5 K/W 降至 0.5 K/W,降幅 67%(如图 13 所示)。
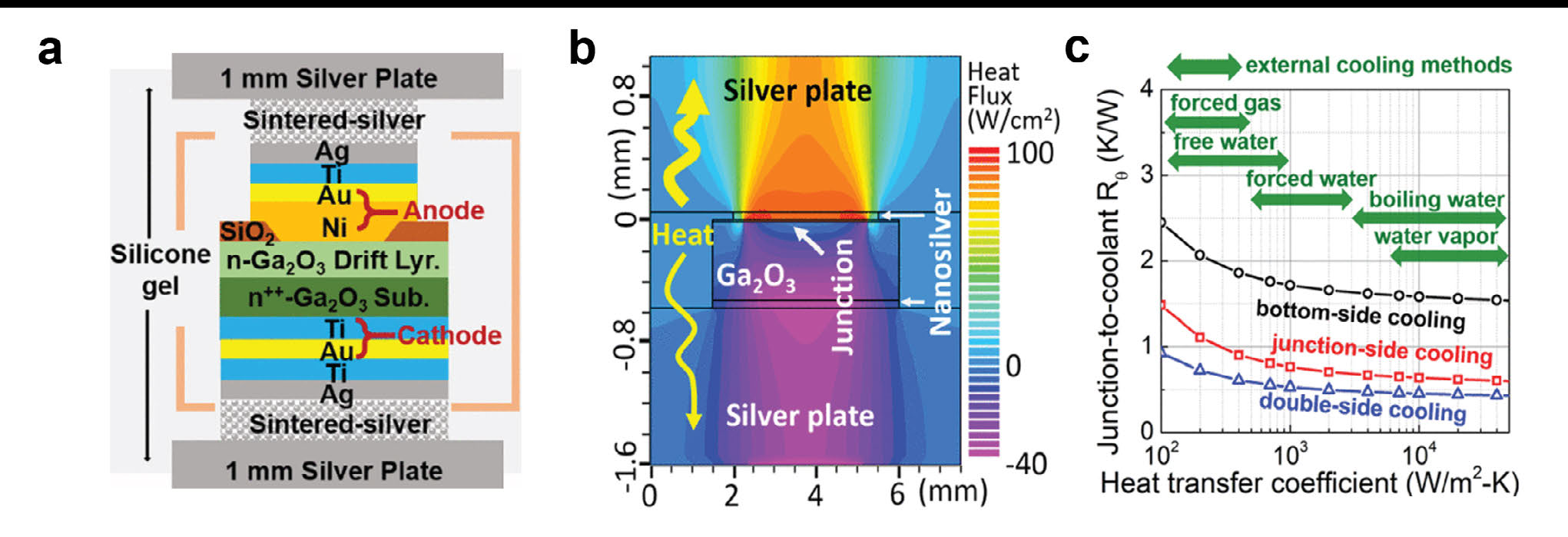
图13。(a)双面冷却的Ga2O3 SBD结构。(b)模拟热通量分布。(c)Ga2O3 SBD在底面冷却、结点冷却和双面冷却 下的模拟热阻。
5. 微通道冷却:主动 “抽水降温”,散热效率天花板
前面的方案都是 “被动导热”,而微通道冷却是主动冷却技术—— 在芯片背面嵌入微小通道,让冷却液(水、液态金属)流动,直接 “带走” 热量,相当于给芯片装了 “微型水冷系统”。
(1)基础微通道:小通道实现高效对流
通道宽度通常为几十到几百微米,冷却液在通道内流动时,与通道壁充分接触,快速吸收热量:
GaN-on-Si HEMT 嵌入微通道后,温度比自然对流降低 98%,120W 输出功率下峰值温度不超过 85℃(如图 14 所示);
GaN-on-SiC HEMT 用微通道冷却,冷却液流量 70 mL/min 时,峰值温度降低 150℃,且无明显电流崩塌(性能稳定)。

图14。(a)液冷氮化镓SBD结构示意图。(b)温差随直流功率密度变化曲线(流量范围0.08-0.83 mL/s)。(c)不同输出功率下的性能对比及表面温度分布。(d)嵌入式冷却技术的氮化镓HEMT结构示意图。(e)远程冷却与嵌入式冷却场景下的温度-热流关联性对比。I–V特性曲线分别对应(f)远程冷却和(g)嵌入式冷却在50 mL/min流量下的表现。经授权转载[92]。 (h) I 与最大表面温度随冷却液流量变化曲线。(i)采用微通道与TSV结构的氮化镓HEMT器件集成方案。
(2)歧管微通道:优化结构,逼近 “冷却极限”
为进一步提升效率,科研人员设计 “歧管微通道”—— 把长通道拆成多个短通道,让冷却液 “分段散热”,减少流动阻力,提升换热效率:
Van Erp 团队设计的 20μm 窄间距歧管微通道,热阻低至 0.4 K/W(接近水冷极限),热流密度超 1000 W/cm²;
10 倍歧管结构在 10W 功率下,器件平均温度降低 130℃,甚至能在 100W 功率下保持温度升高不超过 50℃(如图 15 所示)。

图15。(a)微通道传热设计原理图。(b)红外热成像温度读数显示V D为10V、 为2V时的测量结果。左侧展示远程冷却系统,右侧呈现嵌入式冷却方案。(c)I-V特性曲线对比图,经授权转载[41]。(d)带有复杂微通道冷却技术的氮化镓HEMT结构示意图。(e)单片集成歧管微通道结构(mMMC)内的流体流动可视化。(f)总热阻与流速关系曲线。(g)环境系数(COP)与60 ℃温升(q)下最大热通量的基准对比。(h)温度相关性能对比图.
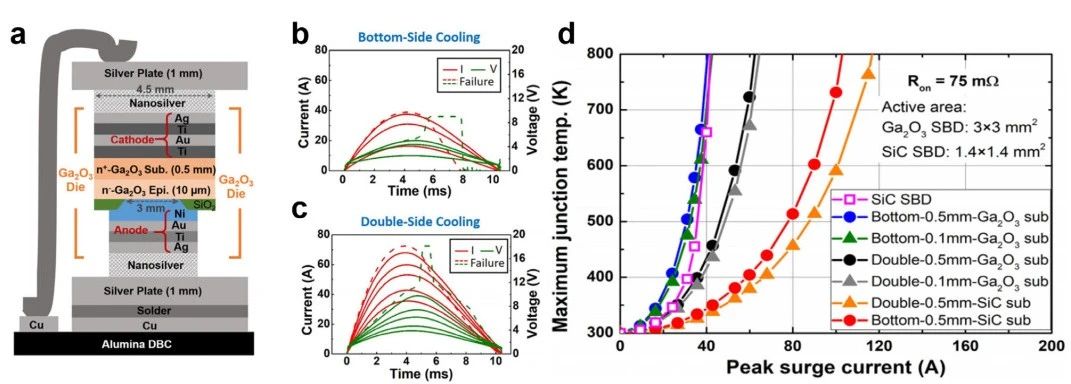
图16:(a)双面冷却倒装芯片封装的Ga₂O3 SBD结构示意图。(b)底部冷却与(c)双面冷却在浪涌电流实验中的电流电压波形对比。(d)10毫秒浪涌测试中峰值浪涌电流与最大结温的仿真关系曲线。
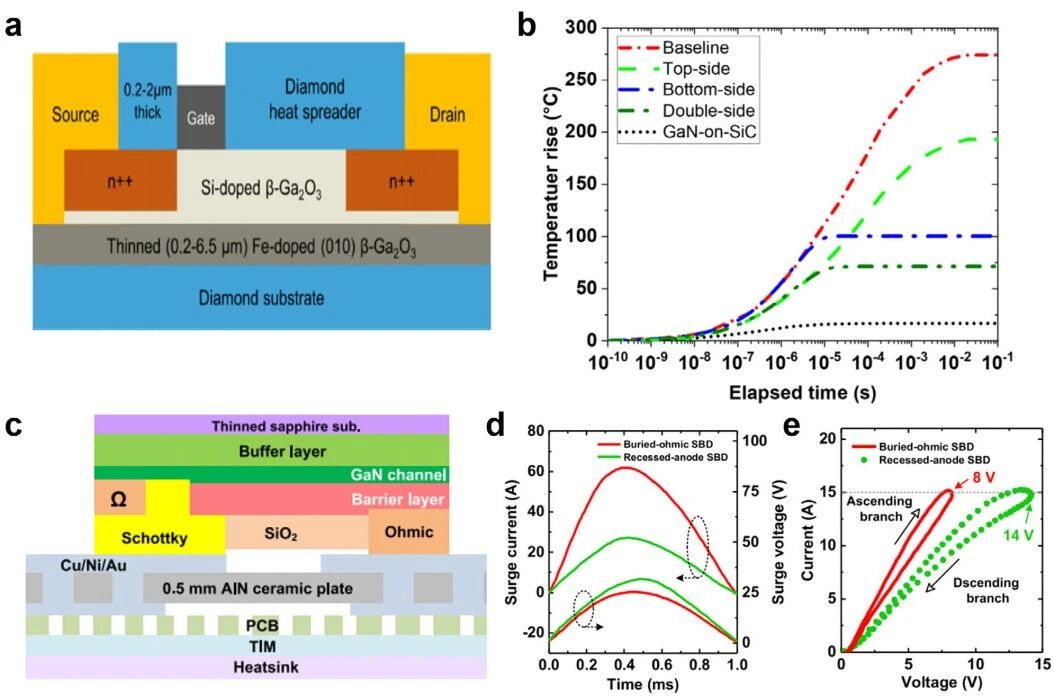
图17。(a)采用金刚石双面冷却的Ga2O3 MOSFET结构示意图。(b)4W/mm功率密度下的瞬态温升曲线,经授权转载 。(c)带倒装芯片封装的埋式欧姆SBD器件截面结构示意图。(d)应力持续时间1 ms时的埋式欧姆与凹陷阳极SBD浪涌电流特性曲线。

表I列举了先进热管理技术在WBG和UWBG器件中的应用最新研究的代表性成果。
(3)未来方向:液态金属冷却
液态金属(如镓基合金)热导率高、沸点高,适合高功率场景。例如,液态金属歧管微通道的对流传热系数可达 10⁶ W/(m²・K),是传统水冷的 10 倍,未来有望解决超宽禁带器件的 “极端散热” 需求。
三、技术怎么选?一张表看懂性价比
不同场景对 “散热效果、成本、工艺复杂度” 的要求不同,综述通过对比,给出了清晰的选择建议。我们整理成表格,方便大家快速参考:

产业优选建议:当前阶段,“SiC 衬底 + 倒装封装” 是性价比最高的组合 ——SiC 衬底解决导热问题,倒装封装缩短热路径,工艺成熟且成本可控,适合大规模应用;微通道冷却虽效果最好,但需解决泄漏与成本问题,未来在高功率密度场景(如新能源汽车逆变器)潜力巨大。
四、未来方向:还有哪些 “黑科技” 值得期待?
综述不仅总结现有技术,还指出了三个前沿研究方向,这些领域可能会诞生下一代散热方案:
固态主动冷却:用电卡材料替代液态冷却液 —— 电卡材料在外加电压下会 “吸热 / 放热”,可在芯片表面形成 “微型冰箱”,无泄漏风险,且能与半导体工艺兼容;
芯片级热电制冷:基于珀尔帖效应,在芯片背面做微型热电单元 —— 电流通过时产生温差,直接给芯片 “降温”,适合局部精准散热;
界面热阻优化:研发新型中间层材料(如二维材料 h-BN),进一步降低 TBR—— 让热量在界面处 “走得更顺畅”,充分发挥高导热衬底的优势。
五、结语:热管理是 WBG/UWBG 产业化的 “关键一跃”
从 GaN 的 175 亿美元市场,到 Ga₂O₃的实验室突破,宽禁带半导体的性能优势已毋庸置疑,但 “散热” 始终是横在产业化面前的一道坎。这篇综述清晰地告诉我们:没有 “万能的散热方案”,只有 “适配的技术组合”—— 消费电子选 “倒装 + SiC 衬底”,高端场景用 “金刚石 + 全包裹散热”,极端功率用 “微通道 + 液态金属”。
随着热管理技术的迭代,未来我们或许能看到:更小体积的 GaN 充电器、更高功率的 Ga₂O₃逆变器、更可靠的 5G 基站芯片 —— 这些 “退烧” 后的宽禁带半导体,将真正释放潜力,推动电力电子行业迈向 “更高能效、更高功率” 的新时代。
原文来源:IEEE Transactions on Electron Devices, Vol. 72, No. 6, June 2025;
作者团队:周佳俊、钟林海、冯欣、周弘、张进成等
本文转发自《亚洲氧化镓联盟》订阅号
